CAMECA SIMS 4550
Ultra low energy quadrupole SIMS for dopant depth profiling and thin layer analysis in semiconductors
The CAMECA SIMS 4550 is a Secondary Ion Mass Spectrometry system for ultra shallow depth profiling, trace element and composition measurements of thin layers in Si, high-k, SiGe and other compound materials such as III-V for optical devices.
- Easy-to-use in-house SIMS for process diagnostics and R&D.
- Maintain high production yields.
- High throughput, with automated features for 24/7 operation.
- Low detection limits, even for new materials like oxynitrides, low-and high-k dielectrics, compound semiconductors and coatings on glass and steel.
- Precise, stable measurements.
Contact us for more information and quotes:
+44 (0)1223 422 269 or info@blue-scientific.com
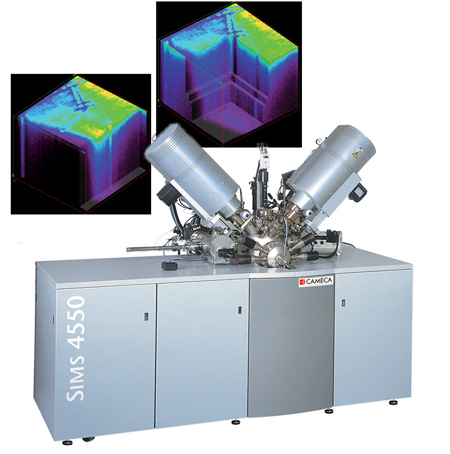
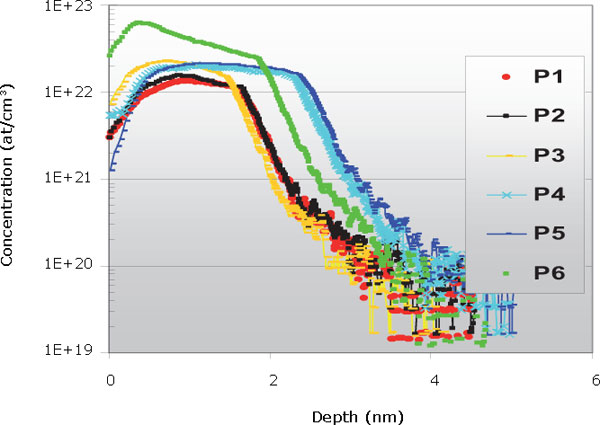
Oxynitride thin layers
High Depth Resolution
With ever-shrinking device dimensions, the CAMECA SIMS 4550 is equipped for implant profiles and layer thickness of semiconductors in the range of 1-10nm. It features an oxygen and cesium high density primary beam with an impact energy programmable from 5keV down to less than 150eV.
Flexible
The CAMECA SIMS 4550 is a flexible dynamic SIMS tool, covering a variety of applications.
- Full flexible sputter conditions (impact angle, energy, species).
- Analyse insulating materials with dedicated options for charge compensation (electron gun, laser) during sputtering.
- Measure layer thickness, alignment, abruptness, integrity, uniformity and stoechiometry.
- Sample holders for small pieces of a few mm² up to 100mm diameter.
High Precision and Automation
The SIMS 4550 has low detection limits for trace elements, with state-of-the-art quadrupole analyser optics and superior peak to background performance. There’s excellent sensitivity for H, C, N and O, with an advanced UHV design with main chamber pressure in the low E-10mbar (E-8Pa) range. Ultra stable ion sources and electronics ensure the highest precision and repeatability of measurements down to < 0.2% RSD.
To minimise human error, the software includes predefined recipes, remote operation and trouble-shooting. For each measurement, full instrument settings are stored in a database – so repeat measurements are only a few mouse clicks away.

Na in Glass

